作者:蘇濬賢、蘇志杰、王裕銘
隨著製程的進步,晶圓內的電晶體逐漸縮小至物理極限,而先進封裝被視為延伸摩爾定律的利器。由台灣-台積電推出的扇出型封裝技術,透過晶片堆疊能使晶片有更高的性能及更小的尺寸,可以滿足消費電子產品不斷增長的需求。先進封裝技術演進趨勢中,扇出晶圓級封裝(fan-out wafer-level packaging, FOWLP)技術被認為是2.5D封裝的替代方法。與扇入晶圓級芯片級封裝(fan-in wafer-level chip-scale package, WLCSP)技術相比,因為直接與IC相結合而不是打線接合或以倒晶封裝,具備無基板封裝、低熱阻以及高性能等優點,能夠實現超薄,高密度封裝的封裝製程[1]。由於市場對於輕薄短小行動裝置的需求不斷增加,因此扇出型晶圓級封裝成為行業趨勢。
隨著先進封裝發展到降低成本與提高整體性能,目前較顯著成長的應用領域包括消費電子、高效能運算與物聯網。此外,隨著半導體IC在汽車領域的日益普及,尤其是電動車與自駕車的技術愈趨成熟,近年來對先進封裝的需求也已大大增加。
以Yole市場分析資料如圖1,2019年先進封裝市場產值超過250億美元,但隨著COVID-19的爆發,中國和日本等國家在全球市場上嚴格執行貨物運輸限制,使關鍵原材料缺料造成斷鏈,加上城市封鎖導致的勞動力問題,許多封裝和測試工廠已經減少甚至停止運營,2020年先進封裝市場產值呈現下降的趨勢。但如圖2預估在2021年開始至2025年期間,受電動車、自駕車、5G及HPC等需求,先進封裝產值呈現持續成長趨勢,複合年均增率預估將達27%。
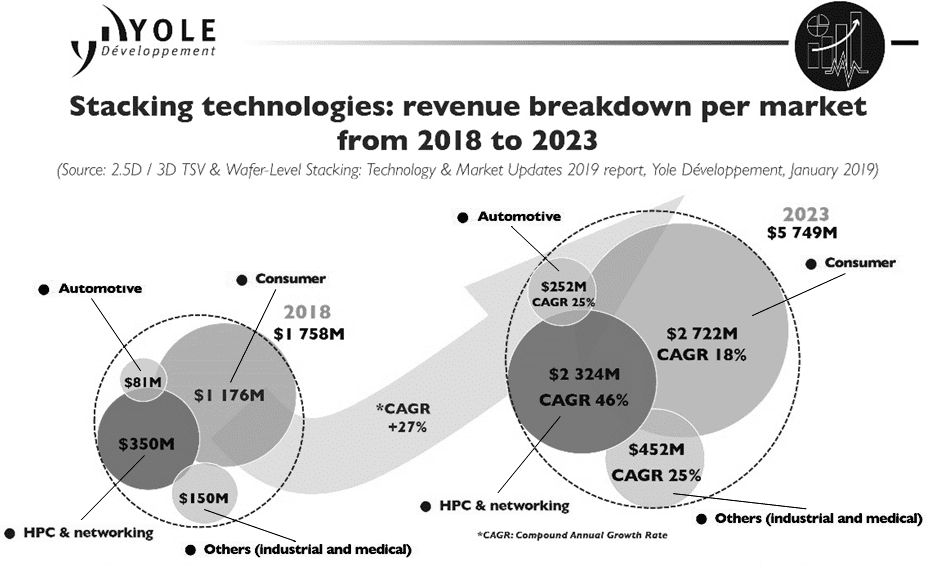
圖1 相關應用領域產值預估 [3]
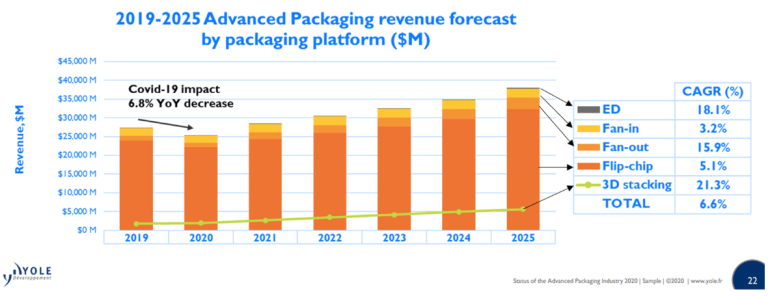
圖2 先進封裝市場現況分析 [3]
以目前的發展來看,在未來數年內,3D堆疊式DRAM及3D邏輯系統單晶片(SOC)的應用將會是3D IC最大的成長動力;接下來就是以2.5D技術切入的CMOS影像感測器、電源設備及MEMS。可預見的是3D IC的技術掀起長達十數年的晶片革命,最終3D IC的封裝技術將會成為未來半導體產業的典範。
由此複雜之先進封裝製程中,晶圓级接合時的對準技術就需更加精準。利用本次專利地圖分析,針對先進封裝設備之晶圓對位軟硬體技術分析,進一步提供國內設備廠或晶圓大廠,提升國內製程品質或開發新型製程技術。此外,工研院機械所預期開發晶圓級封裝設備,晶片封裝設備商EVG的成熟技術既是開發中的學習對象,也是開發完成後的潛在競爭對手,因此也為分析的重點之一。